 Part of the Oxford Instruments Group
Part of the Oxford Instruments Group
Expand
Collapse






The PlasmaPro 100 RIE modules deliver isotropic and anisotropic dry etching for an extensive range of processes. It is suitable for research and production customers, providing a controlled environment that improves process repeatability with load-lock and cassette-to-cassette options.
Single-wafer or batch processing with excellent process control
High control of the gases and plasma power
Excellent uniformity, high throughput and high precision processes
Wide temperature range electrode, -150°C to 400°C
Reactive Ion Etch (RIE) is a predominantly physical etch process. A rich plasma is created just above the wafer and the ions are accelerated toward the surface to produce a powerful and highly anisotropic etch. Gas enters the top of the chamber where it is converted into a reactive plasma at low pressure by a wafer-level RF source. The ions either interact with the sample to form etch by-products, or remain as unreacted species. All the unreacted species and by-products are removed from the chamber by the vacuum pump to maintain a rich and active plasma to maintain high etch rates.
The PlasmaPro 100 RIE delivers reactive species to the substrate, with a uniform high conductance path through the chamber, allowing a high gas flow to be used while maintaining low pressure.
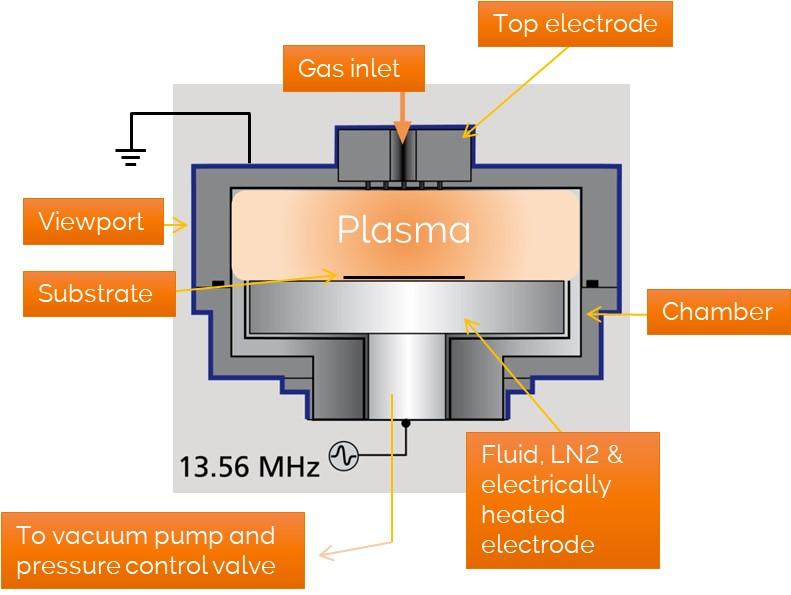
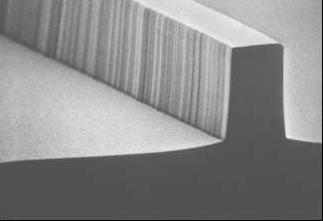
RIE of InP waveguide
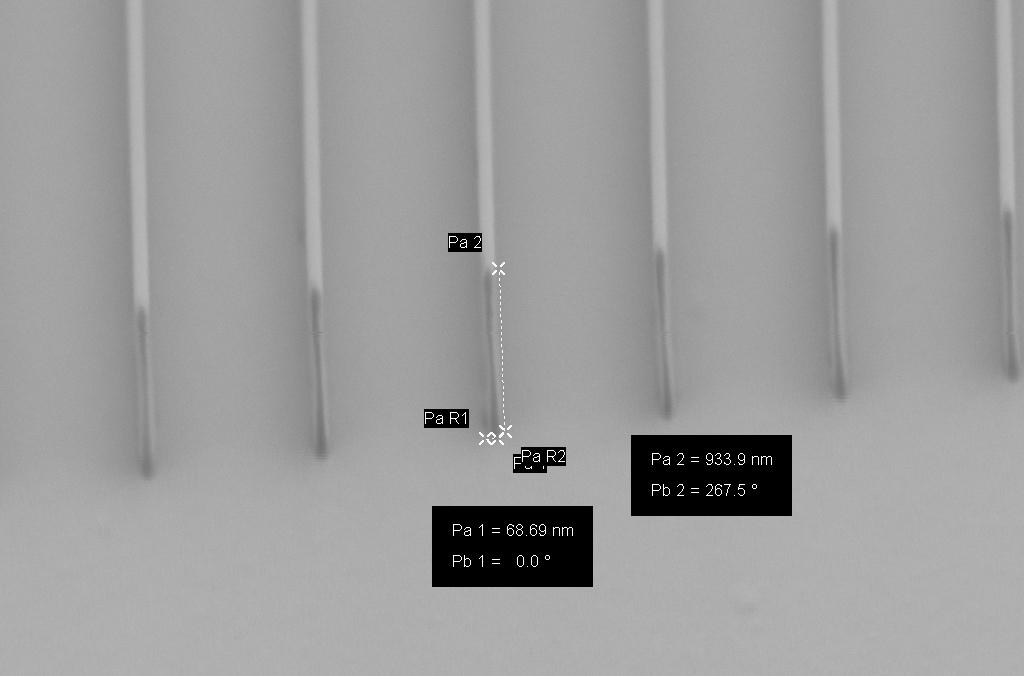
70nm Fused Silica lines 933nm deep Cr mask - Courtesy of Cornell Nanoscience facility
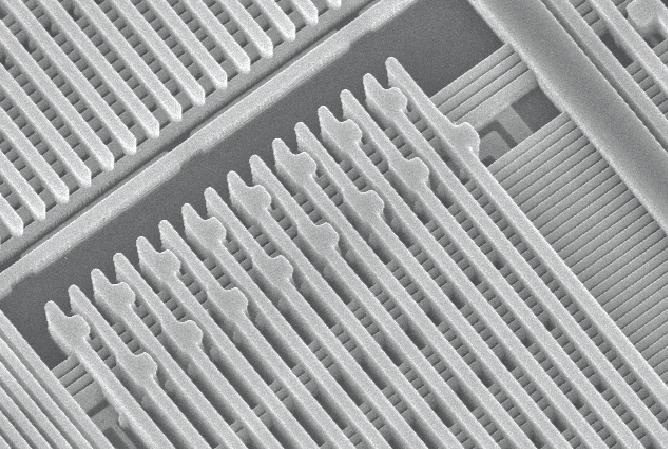
Dielectric metal etch - Courtesy of Atmel
Cluster Load Lock Options
*with MX600ss
Typical Conditions
Advanced Load Lock Options
Oxford Instruments is committed to providing a comprehensive, flexible and reliable global customer support. We offer excellent quality service throughout the life of your system.
PTIQ is the latest intelligent software solution for PlasmaPro and Ionfab processing equipment.
Gas pod - incorporate extra gas lines and allow greater flexibility
Logviewer software - datalogging software allows realtime graphing and post run analysis
Optical end point detectors - an important tool for achieving optimal process results
Soft pump - allows the slow pumping down of a vacuum chamber
Turbomolecular vacuum pump - offers superior pumping speeds and higher throughput
X20 Control System - delivers a future proof, flexible and reliable tool with increased system ‘intellect’
Advanced Energy Paramount generator - Offering increased reliability and greater plasma stability
Automatic pressure control - This controller ensures very fast and accurate pressure control
Dual CM gauge switching - provides the ability to utilise two differing ranges of capacitance manometer via a single pressure control valve
LN2 autochangeover unit - enables table cooling fluid to be automatically switched between Liquid Nitrogen (LN2) and Chiller Fluid
TEOS liquid level sensing - level sensing is achieved using ultra sonic level sensors fitted to the TEOS canister
Wide temperature range electrode - significant design improvements to increase process performance