 Part of the Oxford Instruments Group
Part of the Oxford Instruments Group
Expand
Collapse
PECVD is a well established technique for deposition of a wide variety of films. Many types of device require PECVD to create high quality passivation or high density masks.
Our PECVD systems are specifically designed to produce excellent uniformity and high rate films, with control of film properties such as refractive index, stress, electrical characteristics and wet chemical etch rate. Our plasma cleaning process with end-point control removes or reduces the need for physical/chemical chamber cleaning.
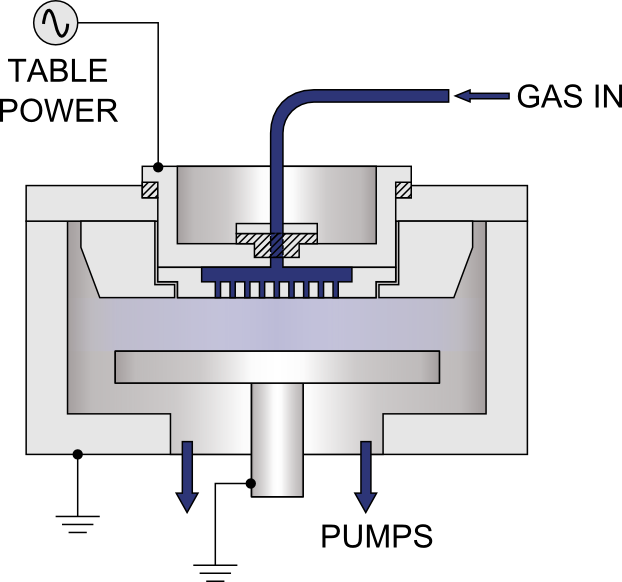
| PlasmaPro 80 | PlasmaPro 100 | PlasmaPro 800 | |
| Electrode size | 240mm | 240mm | 460mm |
| Substrates | Up to 240mm diameter, multi-wafers or small pieces | Up to 200mm diameter with carrier options available for multi-wafers or small pieces | Up to 460mm diameter, multi-wafers or small pieces |
| Dopants | No | Various dopants available which include PH3, 3B2 H6, GeH4 | No |
| Liquid Precursors | No | Yes (TEOS) | No |
| MFC controlled gas lines | 4, 8 or 12 line gas box available | ||
| RF Switching for Stress Control | Yes | ||
| Wafer stage temperature range | 20°C to 400°C | Standard 20°C to 400°C with option for up to 1200°C | Standard 20°C to 400°C |
| Insitu plasma clean | Yes. Endpoint available to ensure optimum clean time | ||

PECVD of vertically aligned graphene (Courtesy of IMEC, Belgium)

PECVD of TEOS SiO2


