 Part of the Oxford Instruments Group
Part of the Oxford Instruments Group
Expand
Collapse
Plasma-enhanced CVD, or PECVD, is a well-established technique for deposition of a wide variety of films. Many types of device require PECVD to create high-quality passivation or high density masks.
The PECVD process modules are specifically designed to produce excellent uniformity and high rate films, with control of film properties such as refractive index, stress, electrical characteristics and wet chemical etch rate.
Inductively Coupled Plasma Chemical Vapour Deposition, ICPCVD. Creation of high-density plasmas in the ICP source means this technique delivers deposition of high-quality dielectric films at low temperature with low damage.
Low temperature deposition means that temperature-sensitive films and devices can be processed successfully.
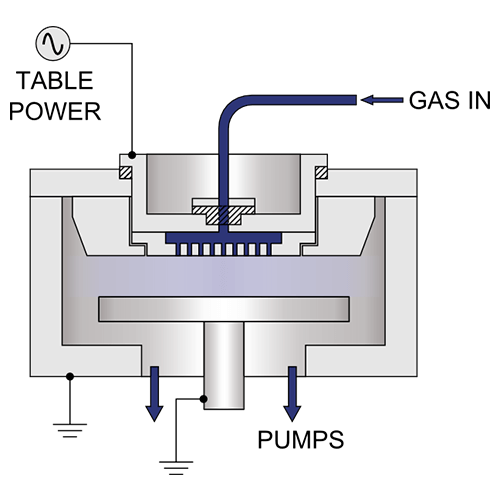
PECVD process and chamber diagram
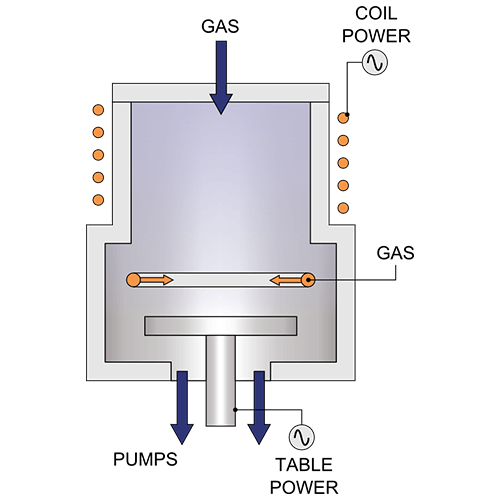
ICPCVD process and chamber diagram
We have developed a process library of over 7,000 recipes. Speak to one of our experts today to discuss your process requirements.
REQUEST MORE INFO

High-quality films, high throughput, excellent uniformity



Excellent uniformity, high throughput and high precision processes
| PlasmaPro 80 | PlasmaPro 100 | PlasmaPro 800 | |||||||||
| Technology | PECVD & ICPCVD | PECVD & ICPCVD | PECVD | ||||||||
| Electrode size | 240mm | 460mm | |||||||||
| Substrates | Up to 240mm diameter | Up to 200mm diameter | Up to 460mm diameter | ||||||||
| Dopants | No | Various available | No | ||||||||
| Liquid precursors | No | Yes (TEOS) | No | ||||||||
| MFC controlled gas lines | 4, 8 or 12 line gas box available | ||||||||||
| Wafer stage temperature range | 20°C to 400°C | 20°C to 1200°C | 20°C to 400°C | ||||||||
| In-situ plasma clean | Yes | Yes | Yes | ||||||||