 Part of the Oxford Instruments Group
Part of the Oxford Instruments Group
Expand
Collapse
ICP RIE etching is an advanced technique designed to deliver high etch rates, high selectivity and low damage processing. Excellent profile control is also provided as the plasma can be maintained at low pressures.
The Cobra® ICP sources produce a uniform, high density plasma with the capability to operate at low pressures. Substrate DC bias is independently controlled by a seperate RF generator, allowing control of ion energy giving excellent results tailored to specific process requirements.
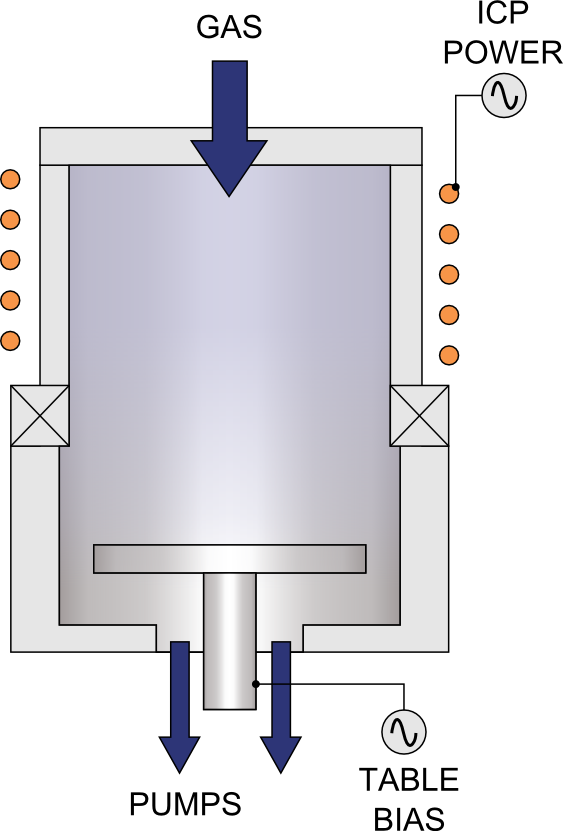
| PlasmaPro 80 |
PlasmaPro 100 | PlasmaPro Polaris | |
| Electrode size | 240mm | ||
| Loading | Open load |
Load lock or Cassette |
Load lock or Cassette |
| Wafer size | Up to 50mm (2")* | Up to 200mm | Up to 200mm |
| MFC controlled gas lines | 8 or 12 line gas box available | 3-5 close coupled gas lines with options for 8-12 external | 8 or 12 line gas box available |
| Wafer stage temperature range | -150 to 400ºC | ||

ICP Etching of a InP showing smooth sidewalls and clean etched surface
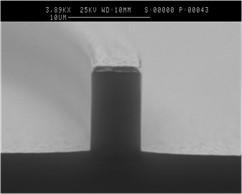
ICP Etching of SiO2 waveguide using a Cr mask