Oxford Instruments has partnered with NYU Nanofabrication Cleanroom to…
 Part of the Oxford Instruments Group
Part of the Oxford Instruments Group
Expand
Collapse
ALE typically involves a cycle of 4 steps that is repeated as many times as necessary to achieve the required etch depth. This example shows ALE of AlGaN etching with Cl2/Ar.
Step 1) Dosing of the substrate with an etching gas, which adsorbs on and reacts with the etch material. The etch gas is often plasma dissociated to enhance the rate of adsorption. With the correct choice of dosing gas and parameters, this can be self-limiting if the chemical dose stops after adsorbing one monolayer.
Step 2) Purging of all residual dose gas.
Step 3) Bombardment of the surface with low energy inert ions which removes the reacted surface layer. This can be self-limiting if the energy of the ions is sufficient to remove the chemically modified layer, but insufficient to (sputter) etch the underlying bulk material.
Step 4) Etching products are purged from the chamber.
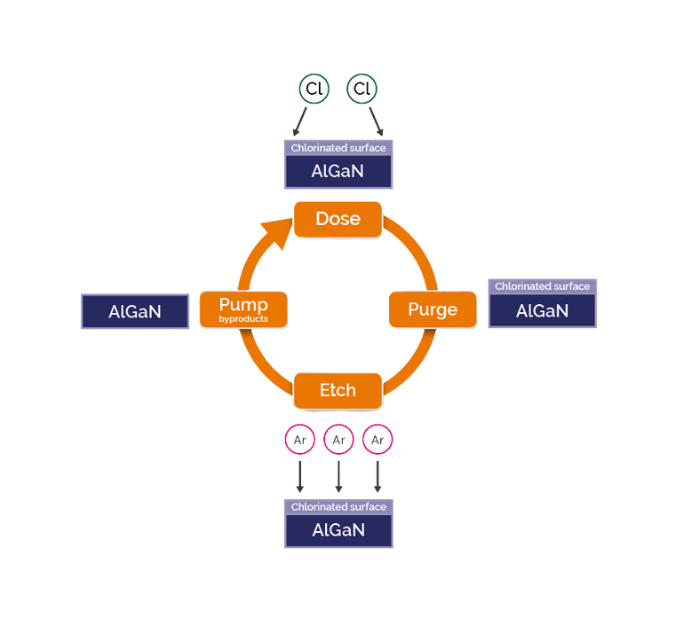

25 nm wide Si trenches etched to 110 nm depth by ALE, HSQ mask still in place.
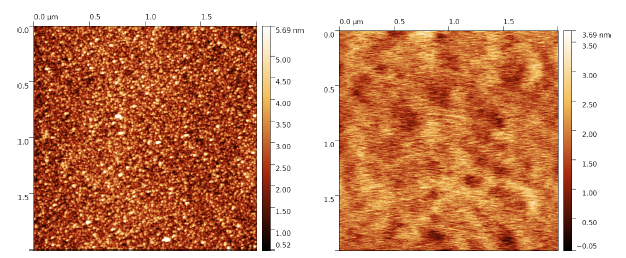
AlGaN surface roughness after 200 ALE cycles, left = before etching (Ra = 600 pm), right = after etching (Ra = 300 pm). The surface has been smoothed by ALE.

ALE of MoS2 shows no Raman defect peak after etching, highlighting the low damage etching capabilities of ALE.
ALE is suitable for a wide range of materials, including Si, a-Si, MoS2, SiO2, GaN, AlGaN, III-V’s, Si3N4, graphene, HfO2, ZrO2, Al2O3, metals etc.
Material etched |
Dose gas |
Ar | |
MoS2 |
Cl2 |
Ar | |
Si or a-Si |
Cl2 |
Ar | |
SiO2 |
CHF3 or C4F8 |
Ar or O2 | |
AlGaN or GaN |
Cl2, BCl3 |
Ar | |
AlGaN or GaN |
N2O |
BCl3 | |
GaAs or AlGaAs |
|
Ar | |
InP or InGaAsP etc. |
CH4, Cl2 |
Ar | |
SiN |
H2 |
Ar | |
Al2O3 |
BCl3 |
Ar | |
Al2O3 |
BCl3 |
Ar | |
Graphene |
O2 |
Ar | |
HfO2, ZrO2 |
Cl2, BCl3 |
Ar |

AlGaN ALE process cycle
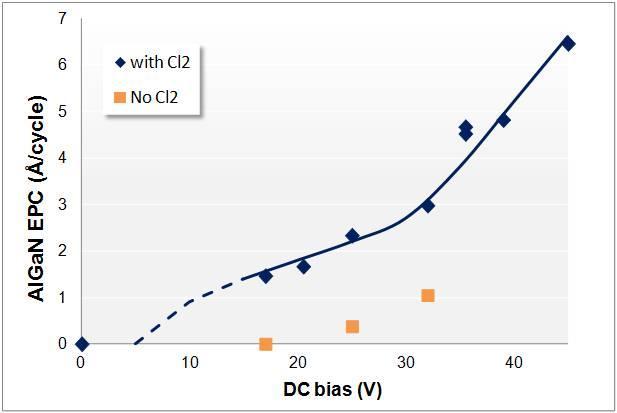
AlGaN etch per cycle with and without chlorine dose
The PlasmaPro 100 ALE delivers precise process control of etching for next-generation semiconductor devices. Specially designed for processes such as recess etching for GaN HEMT applications and nanoscale layer etching, the system's digital/cyclical etch process offers low damage, smooth surfaces.

As layers become thinner to enable the next-generation semiconductor devices, there is a need for ever more precise process control to create and manipulate these layers. The PlasmaPro 100 ALE delivers this by enhancing our Cobra ICP platform with specialised hardware for atomic layer etching.

Oxford Instruments’ PlasmaPro 100 ALE solution delivers precise etching control for cutting-edge specifications and performance requirements of GaN HEMTs manufacturers. With a fully-integrated Etchpoint™ etch depth monitoring solution optimised for GaN and AlGaN layers, and the PlasmaPro 100 ALE system combined provides low damage etching with surface smoothing with unparalleled accuracy in target etch depth for devices such as p-GaN HEMTs and recessed gate MISHEMTs.
The fabrication of GaN HEMTs for power electronics and RF applications is experiencing a massive production ramp driven by the need for efficient, high-performance devices for integration in a wide range of products such as mobile device chargers, electric vehicles, base station transceivers, and datacentres.



5G base stations

Efficient power suppliers for datacentres

Fast chargers for EV

Fast mobile devices charging
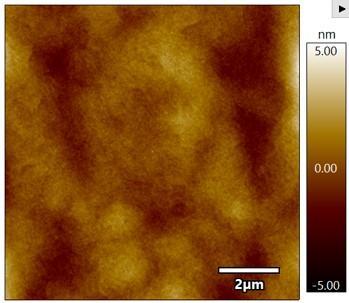
Higher AlGaN surface roughness (0.8 nm Ra) for ICP-RIE process.
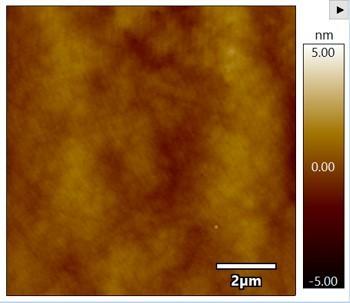
Reduced AlGaN surface roughness (0.4 nm Ra) for ICP-RIE & ALE process.
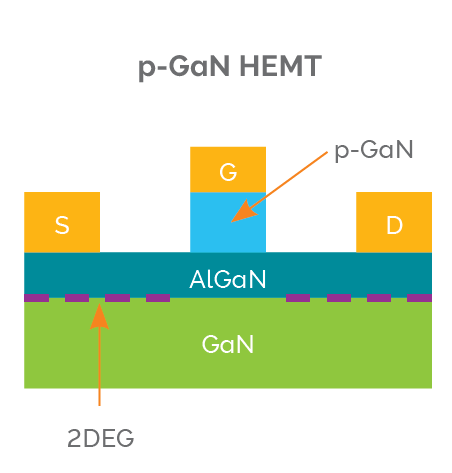
ALE for surface smoothing, low roughness processing of p-GaN devices to enable improved device performance.

GaN surface roughness (0.2 nm Ra) before ALE to demonstrate fully-recessed device with through-AlGaN etch.

GaN surface roughness (0.1 nm Ra) after ALE to demonstrate fully-recessed device with through-AlGaN etch.
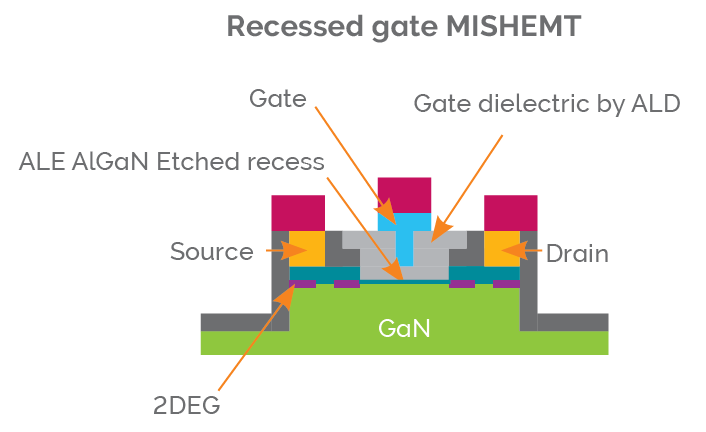
ALE for accurate etch thickness control of remaining AlGaN to ±0.5 nm for partially-etch recess to enable normally-off devices and improved device reliability.
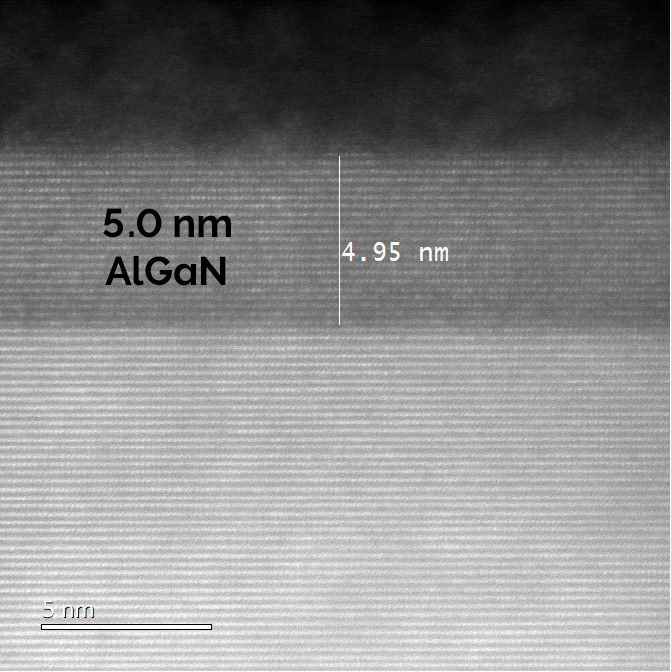

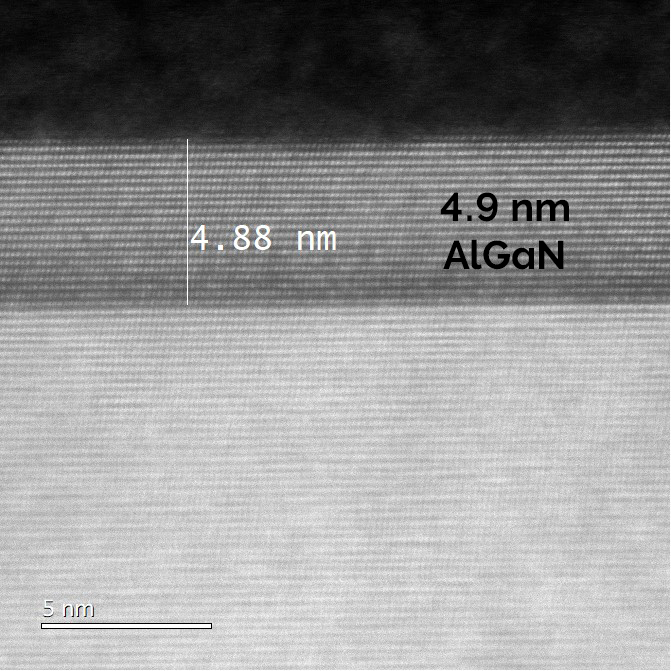
TEM verification across 3 samples of Etchpoint™ accuracy for AlGaN layer. Targeted AlGaN remaining thickness after ALE of 5 nm ±0.5 nm achieved, which was correlated to Etchpoint™ etch traces.
Etchpoint™ is a patent-pending UV reflectance-based endpoint technique with the optimised wavelength selected to allow for unrivalled accuracy of etch layer depth for GaN and AlGaN. Other endpoint solutions can typically achieve ±2 nm resolution which limits the capability to reliably fabricate some GaN HEMT device structures. This new etch-depth monitoring solution has been exclusively developed and optimised by Oxford Instruments in collaboration with LayTec. Etchpoint™ is fully integrated with both the hardware and software of the PlasmaPro 100 ALE system.
Platforms may be clustered to combine technologies and processes with either cassette or single wafer loading options. Hexagonal or square transfer chamber configurations are available.
PlasmaPro 100 Cobra™ load-lock

PlasmaPro 100 Cobra™ twined-cassette cluster

Oxford Instruments is committed to providing a comprehensive, flexible and reliable global customer support. We offer excellent quality service throughout the life of your system.

PTIQ is the latest intelligent software solution for PlasmaPro and Ionfab processing equipment.

At Oxford Instruments Plasma Technology, we offer a wide range of technical training courses designed to suit all skill levels and needs.